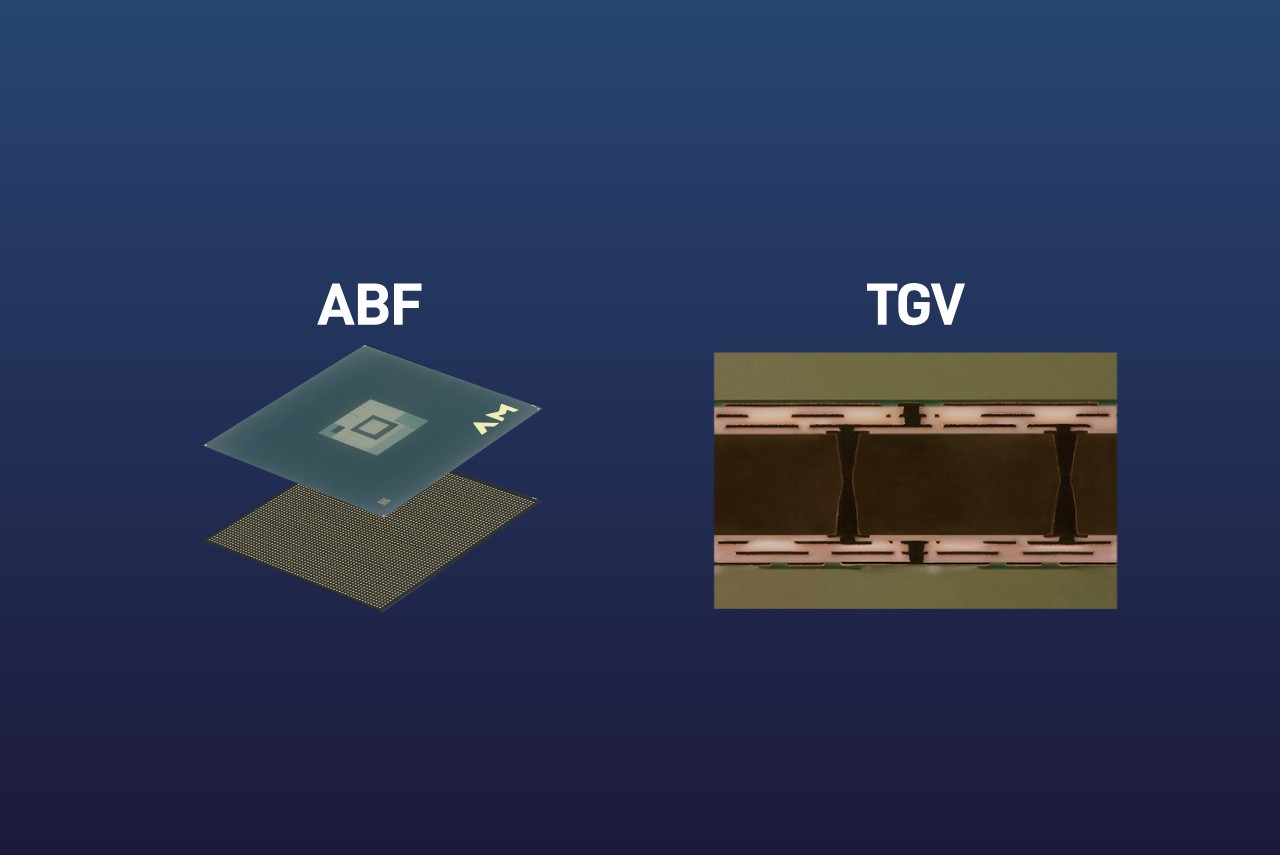
 ABF & TGV 载板
ABF & TGV 载板
ABF 载板
- 尺寸 最大110 x 110mm
- 结构 最大10+N+10
- Bulidup Layer Via/Pad Size (um) Min.50/75
- Bulidup 增层 线宽/线距 间距(um)最小 8/8
- 锡球间距(um)最小90
TGV 载板
- 厦门工厂可对应8+2+8及以上的打样
- TGV通孔孔径100um以下
 BT Substrate
BT Substrate
- 14层任意层互联(芯板/无芯板结构)
- 线宽 / 间距:
・Subtractive: 20/25 um
・mSAP: 12/18 um
・ETS: 12/12 um sample - 130um 节距倒装芯片 CSP/BGA
- 板厚小于0.2mm的6层载板(芯板/无芯板结构)
- 超低CTE,低损耗BT/FR5 材料
- 2.5D空腔,埋线(ETS:Embedded Trace Substrates),薄膜埋容埋阻技术
- 植球技术:SOP( 含print & microball)


 先进的HDI PCBs
先进的HDI PCBs
高可靠性高阶高密度互联技术(HDI)产品量产
高达16层任意层间互联
线宽 / 间距:40/40um
超小间距焊球布局封装(BGA)设计
高达77G Hz的高速材料混压高密度互联(HDI)产品
厚铜、埋铜块以及创新散热解决方案
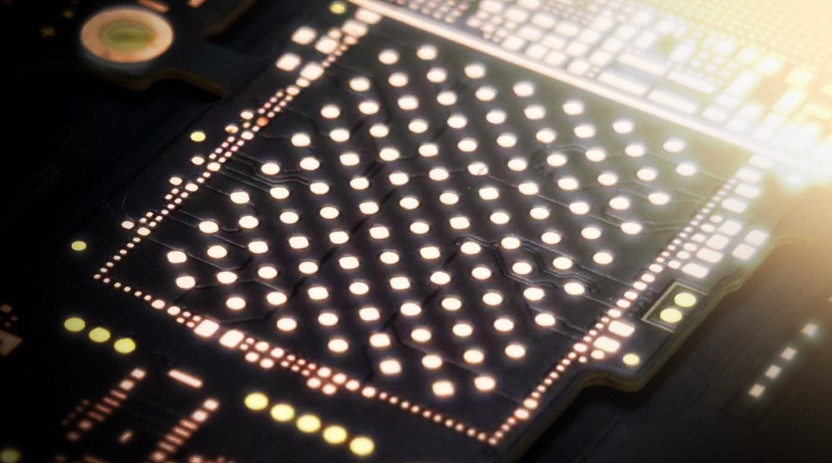
 Substrate-Like-PCB(SLP)
Substrate-Like-PCB(SLP)
- 16层任意层互连
- 110um无芯板厚度
- 线宽线距18/22 um(mSAP)
- 最小倒装芯片距离为127um
- 下一代超高引脚数量 / 精细节距移动装置主板解决方案
- 空腔及2.5D结构
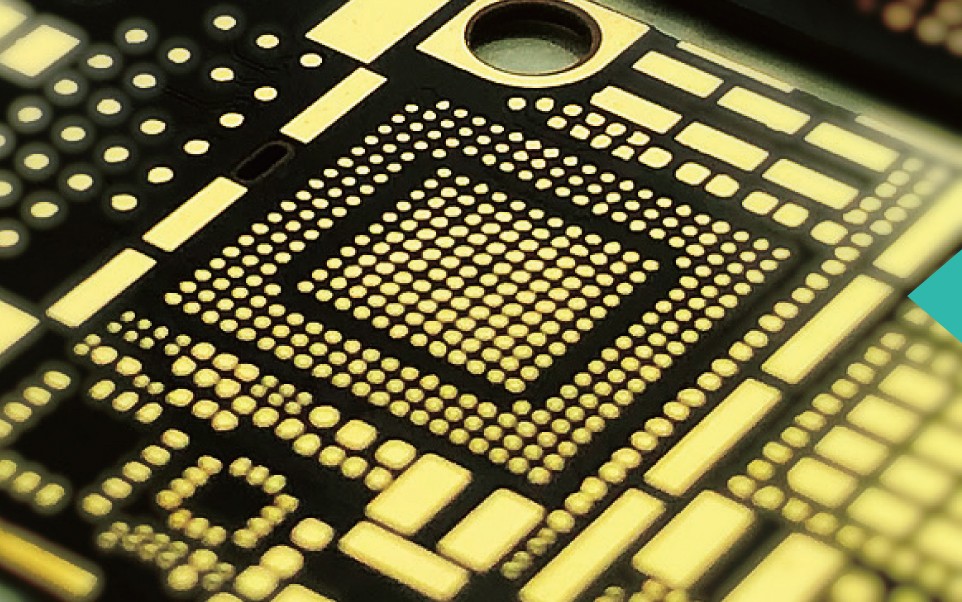
 类载板(SLP)印制电路板(PCBs)
类载板(SLP)印制电路板(PCBs)
采用半加成(mSAP)技术的高可靠性类载板(SLP)产品
(SLP) products with Modified Semi-Additive (mSAP) technology
线宽/线距可以达到30/30微米
超小间距扇出型晶元
针对超大体积数量的封装设计
 HDI及软硬结合板
HDI及软硬结合板
HDI
- 高达18层任意层互连板
- 30 /30 um L/S
- 0.3mm 精细节距BGA
- 高达77G Hz高频材料混压HDI
- 空腔及2.5D结构
软硬结合板
- 高达10层柔性线路的通孔/高阶HDI/任意层互连软硬结合板
- 25 / 25 线宽线距
- 12um Pl,10um超薄覆盖膜软硬结合线路板
- PI/低损耗改性PI/液晶聚合物(LCP)
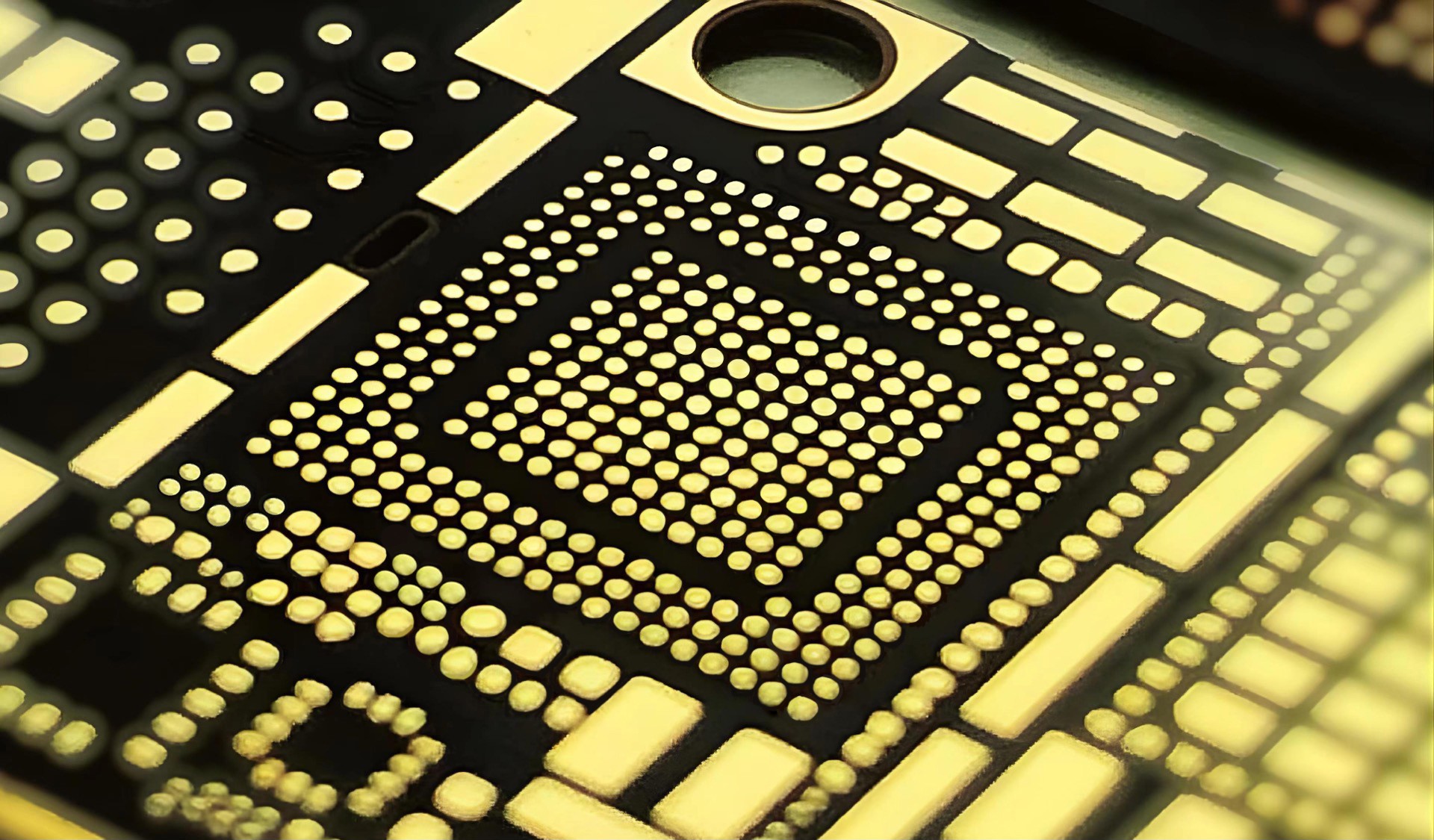

 IC载板
IC载板
超薄及高度定制的封装模块基板
线宽线距可达20/40微米减成法及20/30微米半加成法
150微米节距倒装晶片
<0.2mm 6L有芯板/无芯板(无芯)封装基板
超低热膨胀系数(CTE)BT / FR5材料、低损耗材料以及LED模组应用材料
带静电的2.5维封装(2.5 D)、嵌入式图形线路、分散式埋容埋阻
SOP植球工艺(SOP技术)

 Flex & Assembly
Flex & Assembly
- 30 / 30 线宽线距
- 整板板厚:0.0.6-0.8 mm
- 0.3mm PIN Pitch (连接器及IC芯片)
- 0.35mm Pitch BGA/CSP/Flip chip
- PI / 低损耗改性PI / 液晶聚合物(LCP)
- 静态弯折/动态弯折/半柔性(Semi-Flex)板(FR4弯折软板)Bending FR4 Flex)
- 对称 / 不对称叠构
- 最小贴片规格:01005
 Power Battery Module (CCS)
Power Battery Module (CCS)
- FPC尺寸长达2.4米,FPCA尺寸长达2米,用于温度和电压采集、过电流保护。
- 连接器刺破压接、铝 / 铜超声波焊接
- PET作绝缘膜的热压CCS,热铆工艺的注塑CCS
- 一站式服务,涵盖设计开发、布局、仿真、制造、SMT、测试和组装


 Flex / Flex-assembly / Rigid Flexible (HDI) PCBs
Flex / Flex-assembly / Rigid Flexible (HDI) PCBs
高密度互联柔板/柔板组装/刚柔结合印制线路板
高阶高密度互联(HDI)及任意层间互联柔板/柔板组装/刚柔结合板
线宽 / 间距:40/40um
超小节距晶片
超薄12微米厚度聚醯亚胺(PI)软板、10微米厚度保护膜(覆膜)
动态弯折/安装弯折及半柔性软硬结合板(Semi-flex)
支持对称及非对称结构
聚醯亚胺和低损耗改良聚醯亚胺 /液晶高分子聚合物(MPI / LCP)物料
客制化组装及测试

